Центр коллективного пользования «Микросистемная техника и электронная компонентная база» (ЦКП "МСТ и ЭКБ")
Центр коллективного пользования «Микросистемная техника и электронная компонентная база» (ЦКП "МСТ и ЭКБ"), созданный в 2002 году, является самостоятельным структурным подразделением федерального государственного автономного образовательного учреждения высшего образования «Национальный исследовательский университет «Московский институт электронной техники» (http://miet.ru, 124498, г. Москва, г. Зеленоград, площадь Шокина, дом 1).
Центр коллективного пользования «Микросистемная техника и электронная компонентная база» поддержан в рамках ФЦП, работа по развитию Центра коллективного пользования «Микросистемная техника и электронная компонентная база» осуществляется при финансовой поддержке Министерства науки и высшего образования Российской Федерации. Соглашение № 075-15-2019-1650 (вн. № 05.594.21.0018).
ЦКП МСТиЭКБ проводит научные исследования и разработки, а также предоставляет научно-технические услуги учреждениям, предприятиям и организациям. ЦКП оснащен новейшим оборудованием мирового уровня, позволяющим реализовать замкнутый технологический маршрут проектирования интегральных схем и устройств микросистемной техники с последующим изготовлением фотошаблонов и организацией мелкосерийного производства конечной продукции на отечественных производственных мощностях.
Научные направления деятельности ЦКП осуществляются в рамках приоритетного направления развития науки, технологий и техники в Российской Федерации «Индустрия наносистем» и критических технологий Российской Федерации: «Технологии наноустройств и микросистемной техники»; «Технологии создания электронной компонентной базы и энергоэффективных световых устройств»; «Технологии создания энергосберегающих систем транспортировки, распределения и использования энергии»; «Технологии диагностики наноматериалов и наноустройств»; «Нано-, био-, информационные, когнитивные технологии», утвержденных указом Президента Российской Федерации от 7 июля 2011 года № 899.
АНАЛИЗ МАТЕРИАЛОВ И СТРУКТУР
Основные направления исследований: анализ образцов нано- и микросистемной техники и наноэлектроники (материалов, тестовых структур, изделий на различной стадии готовности).
Проводится комплексное решение проблем при диагностике новых материалов, технологических процессов и калибровки методик пооперационного контроля в производстве.
Особое внимание следует уделить возможности проведения элементного и химического трехмерного качественного и количественного анализа с нанометровым разрешением по трем осям.
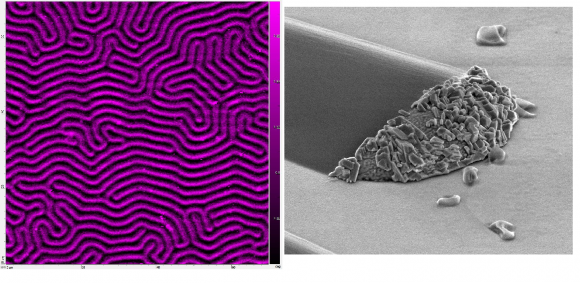

Измерение линейных размеров
- Растровый электронный микроскоп JEOL JSM-6490LV (разрешение 10 нм).
- Двулучевая система FEI Quanta 3D FEG (разрешение 2 нм).
- Сканирующий зондовый микроскоп «SMART-SPM 1000» (разрешение менее 10 нм).
- Оптический микроскоп Nikon Eclipse L200N (увеличение 50х-1500х).
- Стилусные профилометры Alpha-Step D-120, Alpha-Step 200 (точность воспроизведения по Z - 5 А).
- Оптический профилометр Veeco Wyko NT 9300 (разрешение по Z – от 1 нм).
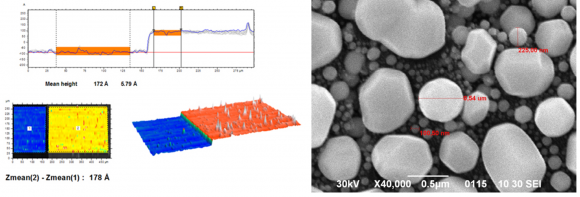
- Просвечивающий электронный микроскоп Titan Themis с корректором сферической аберрации. Ускоряющее напряжение:200 кВ. Разрешение 0,09 нм.
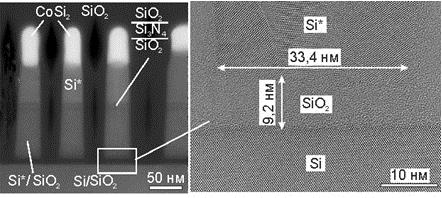
| Поперечное сечение микросхемы памяти | Увеличенное изображение подзатворной области транзистора |
Исследования элементного состава
- Оже-спектрометр PHI-670xi Physical Electronics (разрешение по глубине от 2 А, чувствительность порядка 0,1 атм.%).
- Времяпролётный вторичный ионный масс-спектрометр IonTof TofSims 5 (разрешение по глубине от 2 А, чувствительность порядка 1017).
- Растровый электронный микроскоп JEOL JSM-6490 LV, оснащенный приставкой для энергодисперсионного рентгеновского микроанализа Oxford Instruments 50-X-MAX-20 (предел обнаружения порядка 0,1%).

• Просвечивающий электронный микроскоп Titan Themis c корректором сферической аберрации. Ускоряющее напряжение: 200 кВ. Разрешение: 0,09 нм.
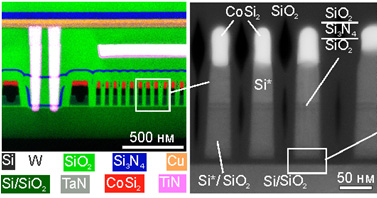
| Распределение элементов в микросхеме памяти | Поперечное сечение микросхемы памяти |
Исследования морфологии поверхности
- Растровый электронный микроскоп JEOL JSM-6490LV (разрешение 10 нм).
- Двулучевая система FEI Quanta 3D FEG (разрешение 2 нм).
- Сканирующий зондовый микроскоп «SMART-SPM 1000» (разрешение менее 10 нм).
- Оптический профилометр Veeco Wyko NT 9300 (разрешение по Z – от 1 нм).

Исследование магнитных характеристик
- Установка измерения магнитооптических параметров методом Керра BH-PI7892V (магнитное поле от -100 до 100 Э).
- Сканирующий зондовый микроскоп «SMART-SPM 1000» (разрешение менее 10 нм).

Исследования структуры
- Многофункциональный рентгеновский дифрактометр Rigaku SmartLab.
- Растровый электронный микроскоп JEOL JSM-6490LV с установленным детектором обратно-рассеянных электронов Bruker Quantax eFlash.
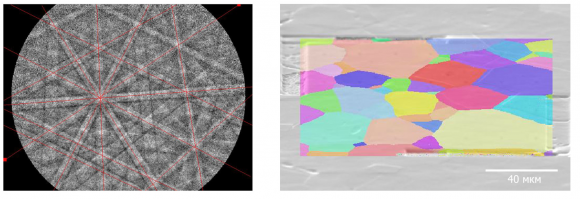
- Просвечивающий электронный микроскоп Titan Themis c корректором сферической аберрации. Ускоряющее напряжение: 200 кВ. Разрешение: 0,09 нм.
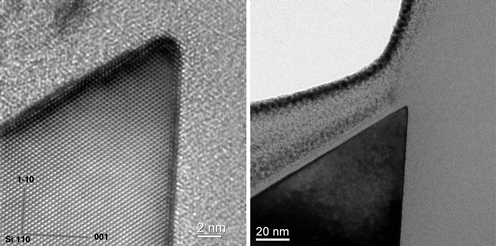
Атомарная структура карбида бора в углеситалле
Исследование оптических характеристик
- Спектральный эллипсометр Horiba Jobin Yvon Auto SE (спектральный диапазон 440-848 нм).
- Спектральный эллипсометр Uvisel 2 (спектральный диапазон 190-2100 нм).
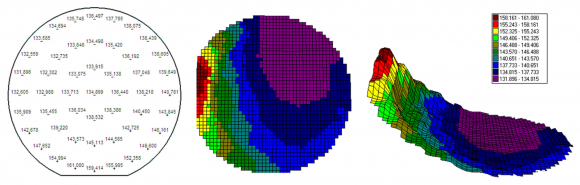
Модификация поверхности
- Двулучевая система FEI Quanta 3D FEG.
- Сканирующий зондовый микроскоп «SMART-SPM 1000».
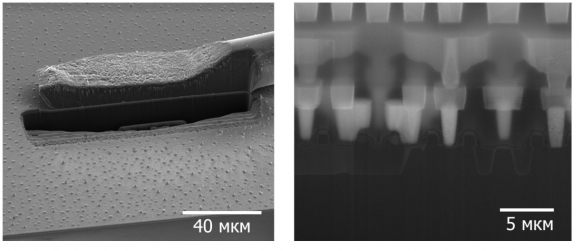
Специализированные исследования
- Высоковакуумная низкотемпературная система «PlasmoScope-2M» для исследования нанорельефа, электростатических, магнитных и тепловых свойств наноструктур методами атомно-силовой микроскопии, сканирующей туннельной микроскопии, магнитной силовой микроскопии.
- Многофункциональный рентгеновский дифрактометр Rigaku SmartLab.
- Установка для измерения поверхностного сопротивления Quad Pro.
Методики измерений, применяемые в ЦКП
- Испытания по ГОСТ 20.57.406 Метод 102, 103, 104-1, 104-5
- Испытания по ГОСТ 20.57.406 Метод 106-1
- Испытания по ГОСТ 20.57.406 Метод 201, 202-1, 203, 204
- Методика измерения линейных характеристик МИС МШУ на полупроводниковой подложке и в составе радиоэлектронного модуля
- Методика измерения фазового шума МИС генераторов, управляемых напряжением (ГУН), умножителей частоты на полупроводниковой подложке и в составе радиоэлектронного модуля
- Методика измерения коэффициента шума монолитных интегральных схем (МИС) малошумящих усилителей (МШУ), фазовращателей с рабочими частотами до 40ГГц, смонтированных на диэлектрической подложке
- Методика временного соединения (bonding) и разъединения (debonding) пластин на жесткий носитель для работы с тонкими пластинами
- Методика количественного определения концентрации элементов методом электронной оже-спектроскопии
- Наименование организации, аттестовавшей методику : Акционерное общество «Научно-исследовательский центр по изучению свойств поверхности и вакуума» (АО «НИЦПВ»)
- Методика лазерного разделения пластин со структурами, формируемыми по технологии 3D сборки
- Методика исследования распределения концентрации бора по глубине в кремнии с помощью вторично-ионного масс-спектрометра
- Наименование организации, аттестовавшей методику : Акционерное общество «Научно-исследовательский центр по изучению свойств поверхности и вакуума» (АО «НИЦПВ»)
- Методика исследования распределения концентрации фосфора по глубине в кремнии с помощью вторично-ионного масс-спектрометра
- Методика измерения локальной ёмкости поверхности образцов с точностью до 25 нм
- Методика получения и анализа изображений, получаемых на оптическом микроскопе Nikon Eclipse, включающая особенности тепнопольной и светлопольной микроскопии отраженного и проходящего света
- Экспресс-метод определения оптических характеристик n и k структуры в целом
- Методика исследования процессов возбуждения автоэлектронной эмиссии
- Методика определения величины плотности заряда в диэлектрической пленке методом вольт-фарадных характеристик
- Методика визуализации пустот после операции бондинга
- Методика герметизации корпуса
- Методика групповой сборки кристаллов и соединения пластин
- Методика жидкостного травления кремния
- Методика измерения магнитных свойств поверхности изделий микросистемной техники с пространственным разрешением в нанометровом диапазоне
- Методика измерения топологических элементов на фотошаблонах
- Методика измерения точностных параметров фотошаблонов
- Методика калибровки измерительных специализированных технических средств, предназначенных для измерения электрических, геометрических и оптических параметров изделий МСТ и ЭКБ
- Методика контроля параметров структуры рельефа поверхности на кремниевых пластинах в процессе изготовления изделий нано-микросистемной техники
- Методика контроля свободно перемещающихся частиц внутри корпуса по уровню шума
- Методика контроля топологи и поиск дефектов на фотошаблонах
- Методика межоперационной и финишной отмывки фотошаблонов
- Методика монтажа пелликлов на фотошаблонах
- Методика напыления тонких пленок металлов
- Методика обработки корпусов
- Методика пиролитических процессов и плазмостимулированного осаждения материалов
- Методика плазменного, реактивно-ионного травления и обработки материалов
- Методика по неразрушающему рентгеновскому контролю полупроводниковых приборов
- Методика посадки кристалла в корпус
- Методика проведения высокоточных измерений напряжений в пленках и подложках на этапах технологического маршрута изготовления структур функциональной электроники
- Методика проведения высокоточных измерений толщин слоев, показателей преломления и состава в многослойных структурах МСТ и ЭКБ
- Методика разделения пластин на кристаллы
- Методика термического окисления кремния
- Методика тестирования активных и пассивных фильтров
- Методика тестирования аналоговых генераторов в диапазоне частот до 500 МГц
- Методика тестирования аналоговых элементов АПЧ и АПФ
- Методика тестирования АЦП, ЦАП
- Методика тестирования буферных усилителей
- Методика тестирования компараторов
- Методика тестирования ОУ
- Методика физико-химической обработки фотошаблонов
- Методика формирования внутренних соединений
- Методика фотолитографии и оптического контроля
- Методика измерения распределения потенциала поверхности методом Градиентного Зонда Кельвина
- Наименование организации, аттестовавшей методику : Акционерное общество «Научно-исследовательский центр по изучению свойств поверхности и вакуума» (АО «НИЦПВ»)
- Методика электрохимического осаждения слоев меди на пластине в структурах 3D сборки
- Методика измерения перепадов высот в нанометровом диапазоне с использованием профилометра
- Методика измерения перепадов высот в нанометровом диапазоне методами сканирующей зондовой микроскопии
- Методика измерения линейных размеров наноструктур методами сканирующей зондовой микроскопии
- Методика измерений линейных размеров наноструктур методами растровой электронной микроскопии
- Методика плазменного реактивно-ионного травления и обработки поверхности
- Методика измерения магнитооптических параметров и доменной структуры изделий нано - и микросистемной техники
- Методика измерения магнитного момента магнитных и ферромагнитных наноструктур при перемагничивании спин-поляризованным током комбинированным методом АСМ/СТМ/МСМ
- Методика измерения оптических характеристик и толщин металлических и диэлектрических пленок, а также многослойных оптически прозрачных структур с принципиально новыми свойствами, с использованием спектрального эллипсометра в спектральном диапазоне 190-2100 нм
- Методика фазового и структурного анализа тонких пленок и наноматериалов с использованием многофункционального рентгеновского дифрактометра
- Испытание на воздействие акустического шума ОСТ11 073.013, 108-1, 108-2
- Испытание на воздействие соляного тумана с покрытием лаком 3 слоя ОСТ11 073.013, 215-1
- Испытание на воздействие инея и росы с покрытием лаком ОСТ11 073.013, 206-1
- Испытание на воздействие плесневых грибов ОСТ11 073.013, 214-1
- Испытание на воздействие атмосферного пониженного давления ОСТ11 073.013, 209-1
- Испытание на воздействие атмосферного повышенного давления ОСТ11 073.013, 406-1, 210-1
- Испытание на хранение при повышенной температуре ОСТ11 073.013,201-1.1
- Испытание на воздействие повышенной влажности воздуха (длительное) с покрытием лаком ОСТ11 073.013, 207-2
- Испытание на прочность при свободном падении ОСТ11 073.013, 408-1
- Испытание на воздействие пониженного атмосферного давления ОСТ11 073.013, 209-4
- Испытание гибких проволочных и ленточных выводов на изгиб ОСТ11 073.013, 110-3
- Кратковременное испытание на безотказность длительностью 3000 ч. ОСТ11 073.013, 700-2,1
- Испытание выводов на воздействие растягивающей силы ОСТ11 073.013, 109-1
- Испытание на теплостойкость при пайке ОСТ11 073.013, 403-1
- Испытание на способность к пайке ОСТ11 073.013, 402-1
- Контроль содержания паров воды внутри корпуса ОСТ11 073.013, 222-1, 222-2
- Методика испытаний датчиков контроля расхода энергоносителей в системах теплоэнергетики
- Методика измерения параметров энергоносителей в системах теплоэнергетики
- Методика испытания изделий МСТ и ЭКБ на воздействие внешних влияющих факторов
- Проверка способности к пайке облуженных выводов без дополнительного облуживания после хранения в течение 12 месяцев ОСТ11 073.013, 402-1 - проводится с целью проверки выводов микросхем легко смачиваться припоем
- Испытание на воздействие статической пыли ОСТ11 073.013 213-1 - проводится с целью проверки способности микросхем работать в среде с повышенной концентрацией пыли
- Испытание на пожарную безопасность ОСТ11 073.013, 410-1, 410-2 - проводится с целью оценки соответствия микросхем требованиям по обеспечению пожарной безопасности, установленным в ТЗ и ТУ на микросхемы
- Испытание на воздействие повышенной влажности воздуха (кратковременное) ОСТ11 073.013, 208-2 - проводится: а) с целью выявления технологических дефектов, если специфика производства и конструктивные особенности изделий таковы, что дефекты могут быть выявлены кратковременным испытанием; б) с целью выявления дефектов, которые могут возникнуть при других видах испытаний. Микросхемы испытывают без электрической нагрузки в камере влаги
- Испытание на воздействие линейных ускорений ОСТ11 073.013, 107-1 - проводится с целью проверки способности микросхем противостоять разрушающему дейтсвию линейного ускорения и сохранять свои параметры после воздействия линейного ускорения
- Испытание на воздействие изменения температуры ОСТ11 073.013, 205-1, 205-3 - проводится с целью определения способности микросхем сохранять свой внешний вид и параметры после воздействия изменения температуры среды в пределах значений, установленных в ТУ на микросхемы
- Проверка габаритных, установочных и присоединительных размеров ОСТ11 073.013, 404-1 - проводится с целью определения соответствия габаритных, установочных и присоединительных размеров микросхем требованиям ТУ на микросхемы
- Испытание на чувствительность к разряду статического электричества ОСТ11 073.013, 502-1, 502-1а - проводится с целью определения допустимых знгачений статического электричества для микросхем и определения их соответствия заданному в технической документации допустимому значению статического электричества
- Проверка массы микросхемы ОСТ11 073.013, 406-1 - проводится с целью проверки соответствия массы микросхем требованиям, установленным в ТУ на микросхемы
- Определение запасов устойчивости к воздействию механических , тепловых и электрических нагрузок (граничные испытания) ОСТ11 073.013, 422-1 - проводится при проведении приемки ОКР с целью определения: запасов устойчивости микросхем и корпусов к различным видам внешнего воздействия; предельных значений электрических режимов и минимальных значений предельно допустимых электрических режимов эксплуатации; резонансных частот микросхем
- Проверка габаритных размеров индивидуальной, групповой, дополнительной и транспортной тары ОСТ11 073.013, 404-2 - проводится с целью определения соответствия габаритных размеров индивидуальной, групповой, дополнительной и транспортной тары технической документации и ТУ
- Испытание на виброустойчивость ОСТ11 073.013, 102-1 - проводится с целью проверки способности микросхем выполнять свои функции и сохранять внешний вид и параметры в пределах норм установленных в ТУ на микросхемы в условиях и после воздействия синусоидальных вибраций в заданных режимах
- Испытание на вибропрочность ОСТ11 073.013, 103-1.1, 103-1.3 - проводится с целью проверки способности микросхем противостоять разрушающему действию вибрации и сохранять внешний вид и параметры в пределах норм установленных в ТУ на микросхемы после ее воздействия
- Испытание на воздействие одиночных ударов ОСТ11 073.013, 106-1 - проводится с целью проверки способности микросхем противостоять разрушающему действию механических ударов одиночного действия и сохранять внешний вид и параметры после воздействия ударов
- Испытание на влагостойкость в циклическом режиме ОСТ11 073.013, 207-4 - проводится с целью ускоренной оценки устойчивости микросхем и материалов, из которых они изготовлены, к разрушительному действию высокой влажности и температуры, характерных для тропического климата
- Кратковременное испытание на безотказность длительностью 1000 ч. - проводится с целью периодического контроля качества микросхем и проверки стабильности технологического процесса изготовления
- Испытание соединения кристалл- подложка на сдвиг ОСТ11 073.013, 115-1 - проводится с целью определения прочности соединений между кристаллом и держателем или подложкой и оценки качества крепления кристалла
- Контроль прочности сварного соединения ОСТ11 073.013, 109-4 - проводится с целью проверки прочности сварных соединений проволочных и ленточных выводов с контактными площадками кристалла, подложки (для гибридных схем) или траверсами корпуса и перемычек схем
- Внутренний визуальный контроль ОСТ11 073.013, 405-1.1 - метод предназначен для контроля кристаллов полупроводниковых микросхем, включая кристаллы третьей и высшей степени интеграции с металлизацией, защищенной и незащищенной диэлектрической пленкой и контроля качества сборки ИС
- Испытание на воздействие очищающих растворителей ОСТ11 073.013, 411-1 - проводят с целью проверки стойкости к воздействию очищающих растворителей наружных материалов (неметаллических покрытий) и маркировки микросхем выполненной лакокрасочными материалами, и (или) определение способности микросхем сохранять свои параметры в пределах значений, указанных в ТУ
- Проверка качества маркировки ОСТ11 073.013, 407-1 - осуществляется с целью определения содержания и разборчивости маркировки
- Испытание на герметичность ОСТ11 073.013, 401-8, 401-9 - представляет собой приборную проверку герметичности микросхем путем обнаружения утечки введенного в них элегаза или содержащегося в них воздуха
- Проверка статических параметров ОСТ11 073.013, 500-1, 203-1, 201-2,1 - проводится с целью проверки соответствия электрических параметров нормам, установленным в ТУ. Испытания проводят средствами измерений, приборами и приспособлениями, удовлетворяющими требованиям стандартов на методы измерения электрических параметров микросхем
- Проверка внешнего вида микросхем ОСТ 11 073.013,405-1.3 - проводится с целью определения соответствия внешнего вида требованиям ТУ, образцам внешнего вида или "Описанию образцов внешнего вида"
- Методика испытания изделий с определением концентрации паров воды в газовой смеси (200-10500) млн-1
- Методика испытания изделий на воздействие температуры в диапазоне от минус 80 до плюс 220 ºС
- Методика испытания изделий с воспроизведением линейных ускорений до 50 g
- Методика испытания изделий с воспроизведением нагрузок от 1 N до 50 NМетодика испытания изделий с воспроизведением вибрации до 20 g в диапазоне частот от 40 Гц до 200 Гц
- Методика испытания изделий с воспроизведением ударного ускорения от 100 g до 15000 g при длительности ударного импульса от 1 мс до 2 мс
- Методика испытания изделий на воздействие температуры в диапазоне от 40 ºС до 300 ºС
- Методика контроля микросхем с функцией томографии
- Методика испытания изделий с диапазоном измерения утечки газов от 5 Е-12 м3*Па/с до 1 м3*Па/с
- Методика испытания изделий с воспроизведением и измерением напряжения и силы постоянного тока, частоты следования прямоугольных импульсов при высоковоспроизводительном функциональном и параметрическом контроле интегральных микросхем и кристаллов в составе полупроводниковой пластины с числом выводов до 256 и рабочей частотой последовательности функционального контроля до 500 МГц
- Методика контроля прочности присоединения кристаллов и прочности сварных соединений
- Методика испытания изделий в диапазоне температуры от минус 85 ºС до 160 ºС с отклонением температуры от заданного значения ±2 ºС
- Методика испытаний технических изделий на стойкость к воздействию влажности
- Методика испытания изделий с воспроизведением амплитуды виброперемещения от 0,1 мм до 24,4 мм, виброскорости от 0 м/с до 1,7 м/с, ускорения от 0,1 g до 50 g в диапазоне частот от 5 Гц до 3000 Гц
- Методика электротермотренировки элементов функциональной электроники

